2024
Skúmanie štrukturálnych, optických a elektrónovo-transportných vlastností lítiom interkalovaných viacvrstvových MoS₂: Odhaľovanie vplyvu neusporiadanosti
Molybdén disulfid (MoS2) patrí medzi často študované materiály, pre jeho vrstevnatú štruktúru, výnimočné vlastnosti a použiteľnosť v elektronike, optoelektronike, či lítiových batériách. Vrstevnatá štruktúra MoS2 umožňuje interkaláciu cudzích atómov do van der Waalsovského priestoru medzi vrstvami, čo môže ovplyvniť elektronickú štruktúru materiálu, ale aj elektrické či optické vlastnosti.
V našej práci sme sa venovali interkalácii tenkých MoS2 vrstiev lítiom, ktoré boli pripravené dvoma rôznymi technikami – teplotnou konverziou (TAC) a pulznou laserovou depozíciou (PLD). Ako zdroj lítia sme používali práškové Li2S, ktoré sme spolu s práškovou sírou zahriali na vysokú teplotu. Lítium sa vďaka difúzii dostalo do priestoru medzi vrstvami MoS2. Prítomnosť lítia vo vzorkách sme overili pomocou fotoelektrónovej spektroskopie. Výrazne štrukturálne zmeny, ani zmeny v optických vlastnostiach vrstiev sme po interkalácii nezaznamenali. Avšak elektrický odpor vzoriek s obsahom lítia výrazne narástol. Vďaka meraniu teplotnej závislosti odporu sme zistili, že transport nosičov v našich vrstvách najlepšie opisuje Efros-Shklovskiiho transport s premenlivou dĺžkou skoku. Takáto závislosť je typická pre poruchový polovodič. Keďže odpor vrstiev výrazne rástol so stúpajúcim obsahom lítia, môžeme konštatovať, že lítium zavádzalo do našich vrstiev nové poruchy, ktoré sa prejavili zvýšeným odporom a ak aj lítium dotovalo elektróny do MoS2 vrstiev, tento efekt ostal skrytý v dôsledku prevládajúceho efektu porúch.

Závislosť elektrického odporu od teploty, x pre LixMoS2 značí obsah lítia v MoS2 vrstvách.
2023
Lítiom indukovaná reorientácia veľmi tenkých vrstiev MoS2
Pri našom výskume sme sa sústredili na sledovanie vplyvu lítia na rast ultratenkých vrstiev disulfidu molybdénu (MoS2). Pozitívny vplyv lítia sa už ukázal pri zvýšenom katalytickom výkone MoS2 vrstiev dopovaných lítiom pri produkcii vodíka a redukcii CO2. Dopovanie lítiom má tiež potenciál zlepšiť technológiu lítiových batérií.
MoS2 je vrstvený materiál, ktorý možno pripraviť vo forme jednej alebo len niekoľkých vrstiev. Vďaka svojim zaujímavým vlastnostiam a širokej škále možných aplikácií je tento materiál predmetom rozsiahleho štúdia. Interkalácia je jedným zo spôsobov, ako ovplyvňovať fyzikálne, chemické a elektronické vlastnosti materiálov. Vplyv lítia na rast MoS2 vrstiev však doteraz nebol úplne preskúmaný.
V našej práci sme použili nový prístup na zabudovanie lítia do MoS2 vrstiev. Na výrobu MoS2 používame jednozónovú sulfurizáciu vopred nanesených molybdénových vrstiev. Ako zdroj lítia sme použili sulfid lítny. Štrukturálne analýzy ukazujú pozoruhodný účinok lítia, a to podporu epitaxného a horizontálneho rastu vrstiev. Po žíhaní v prítomnosti Li majú MoS2 vrstvy tendenciu rásť horizontálne aj pre hrubšie počiatočné vrstvy molybdénu. Najprekvapivejším pozorovaním je konverzia vertikálnych MoS2 vrstiev na horizontálne po žíhaní v prítomnosti Li. Predpokladáme, že lítium pôsobí ako katalyzátor uľahčujúci túto konverziu.
Naša práca demonštruje, že pomocou dopovania lítiom je možné meniť orientáciu bazálnej roviny MoS2 vo veľmi tenkých vrstvách. Ako už bolo ukázané, vertikálne a horizontálne orientované vrstvy vykazujú odlišné elektronické, chemické a optické vlastnosti. Kontrola nad kryštalografickou orientáciou MoS2 bude teda rozhodujúca pri navrhovaní zariadení novej generácie obsahujúcich vrstvy MoS2.
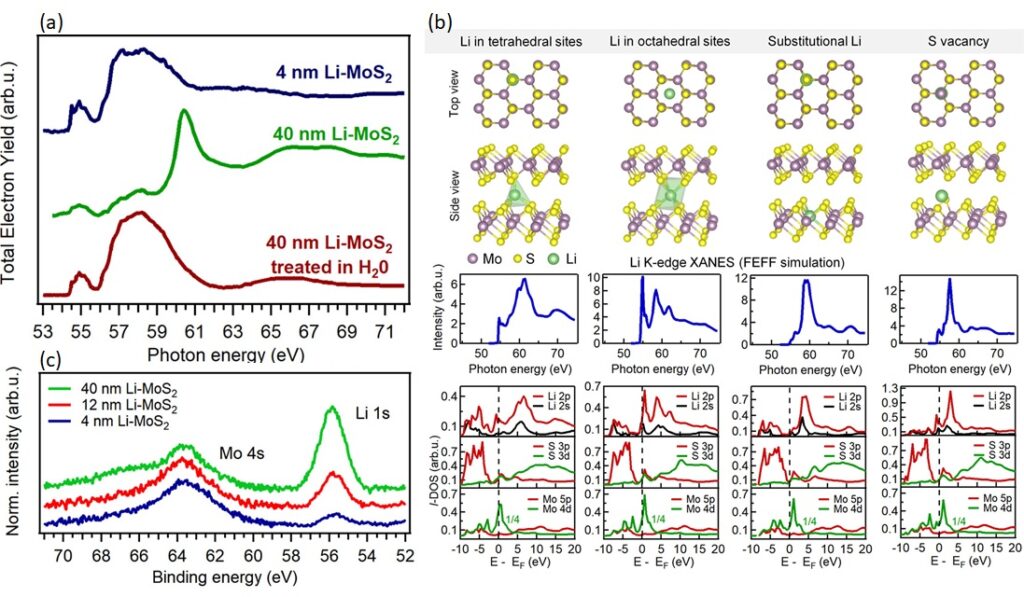
(a) Li K-edge XANES experimentálne spektrá pre Li dopovaný 2H-MoS2.
(b) Li K-edgeXANES spektrá získané výpočtami FEFF. Hore: fragmenty štrukturálnych modelov pre hexagonálny 2H-MoS2 s atómami v tetraedrických a oktaedrických intersticiálnych miestach, substitučne dopovaným MoS2 a s lítiom v blízkosti atómu síry. Stred: simulované Li K-edge XANES spektrá. Dole: vypočítaná orbitálna projektovaná hustota stavov pre Li, S a Mo atómy. (c) Mo 4s a Li 1s XPS spektrá zo vzoriek MoS2 dopovaných Li.
Výstupy:
Sojková, M., Píš, I., Hrdá, J., Vojteková, T., Pribusová Slušná, L., Vegso, K., Šiffalovič, P., Nádaždy, P., Dobročka, E., Krbal, M., Fons, P.J., Munnik, F., Magnano, E., Hulman, M., and Bondino, F.: Lithium-induced reorientation of few-layer MoS2 films, Chem. Mater. 35 (2023) 6246-6257.
2022
Analýza nehomogénnych Au/Ni/4H-SiC Schottkyho diód a priesečníka ich teplotne závislých I-V charakteristík
V súvislosti s prípravou detektorov radiačného žiarenia s povrchovou bariérou z materiálu 4H-SiC sme študovali teplotnú závislosť elektrických parametrov Schottkyho bariéry Au/Ni/4H-SiC v rozsahu teplôt 35 – 80 °C [1]. Prúdovo napäťové (I-V) krivky (obr. 1) nemali v semilogaritmickom zobrazení lineárnu časť, čo býva dôsledkom nehomogenity vo výške Schottkyho bariéry. I-V krivky sme preto analyzovali pri predpoklade Gaussovského rozdelenia výšky bariér na ploche diódy a paralelného radenia čiastkových diód s im prislúchajúcimi sériovými odpormi. Metódou najmenších štvorcov sme určili strednú hodnotu rozdelenia bariér, jej strednú kvadratickú odchýľku a sériový odpor diódy ako funkciu teploty (obr. 2).
Extrahovaná stredná výška bariér rovnako ako aj stredná kvadratická odchýľka klesali s rastúcou teplotou. Naopak, sériový odpor diódy s rastúcou teplotou rástol. Dôsledkom rastúceho odporu bol priesečník I-V kriviek v spoločnom (alebo približne spoločnom bode). V okolí tohto napäťového bodu tečie diódou prúd, ktorý je skoro nezávislý (veľmi málo závislý) od teploty.
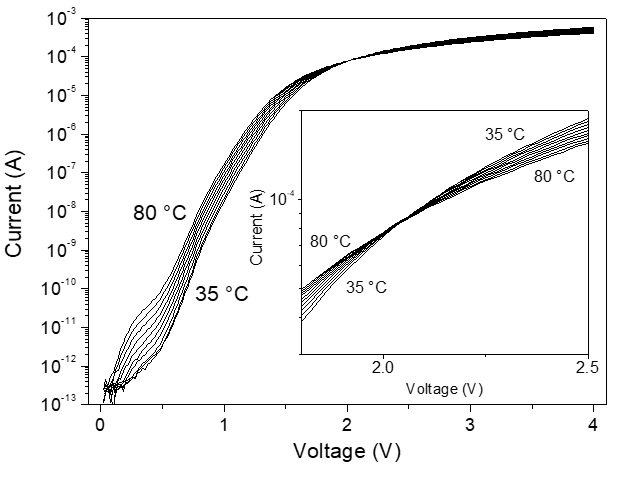
Obr. 1

Obr. 2
V ďalšom sme analyzovali, či ide o jediný priesečníkový bod, alebo ide o určitý napäťový interval, v ktorom sa I-V krivky pretínajú [2]. Štúdiu sme vykonali pre tri prípady – homogénnu diódu, nehomogénnu diódu, ktorú je možno pokladať za súbor menších diód, z ktorých každá má svoj sériový odpor a nehomogénnu diódu so spoločným sériovým odporom. V študovanom teplotnom rozsahu 300 – 400 K sme pre diódy s určitými parametrami zistili numerickými metódami, že najmenší rozptyl medzi napätiami (prúdmi) priesečníkov kriviek vykazuje homogénna dióda, vyšší roztyl je pri nehomogénnej dióde so spoločným sériovým odporom a najväčší je pri nehomogénnej dióde, ktorá má charakter paralelného radenia menších diód so svojim vlastným sériovým odporom.
Výstupy:
[1] Osvald, J., Hrubčín, L., and Zaťko, B.: Temperature dependence of electrical behaviour of inhomogeneous Ni/Au/4H–SiC Schottky diodes, Mater. Sci Semicond. Process. 140 (2022) 106413. IF: 4.644
[2] Osvald, J.: Intersection of 4H-SiC Schottky diodes I–V curves due to temperature dependent series resistance, Semicond. Sci Technol. 37 (2022) 125003. IF: 2.048
2021
Výroba a príprava veľmi tenkých PtSe2 vrstiev
Veľmi tenké vrstvy PtSe2 sú sľubnými kandidátmi na aplikácie vo vysokorýchlostnej elektronike, spintronike a pre fotodetektory. Epitaxné vrstvy PtSe2 boli pripravené na c-zafírovej podložke pomocou jednozónovej selenizácie vopred naprášených platinových vrstiev. Filmy vykazujú znaky usporiadania v rovine na veľké vzdialenosti pripomínajúce epitaxný rast. Použitie zvýšenej teploty viedlo k zvýšenej kryštalinite a lepším elektrickým vlastnostiam. Okrem toho sme identifikovali pomer Se : Pt ako parameter riadiaci pohyblivosť nosičov náboja vo vrstvách. Pohyblivosť sa zvyšuje viac ako dvakrát, keď sa pomer mení v úzkom intervale okolo hodnoty 2. Očakáva sa, že spojenie polovodiča so supravodičom na jednej platforme poskytne zariadeniam lepší výkon. Pripravili sme tenké vrstvy PtSe2 na povrchu NbN. Zistili sme, že parametre selenizácie zachovávajú chemickú a štrukturálnu integritu filmov PtSe2 aj NbN.Orientáciu PtSe2 možno ovplyvniť zmenou rýchlosti prietoku dusíka cez reakčnú komoru.
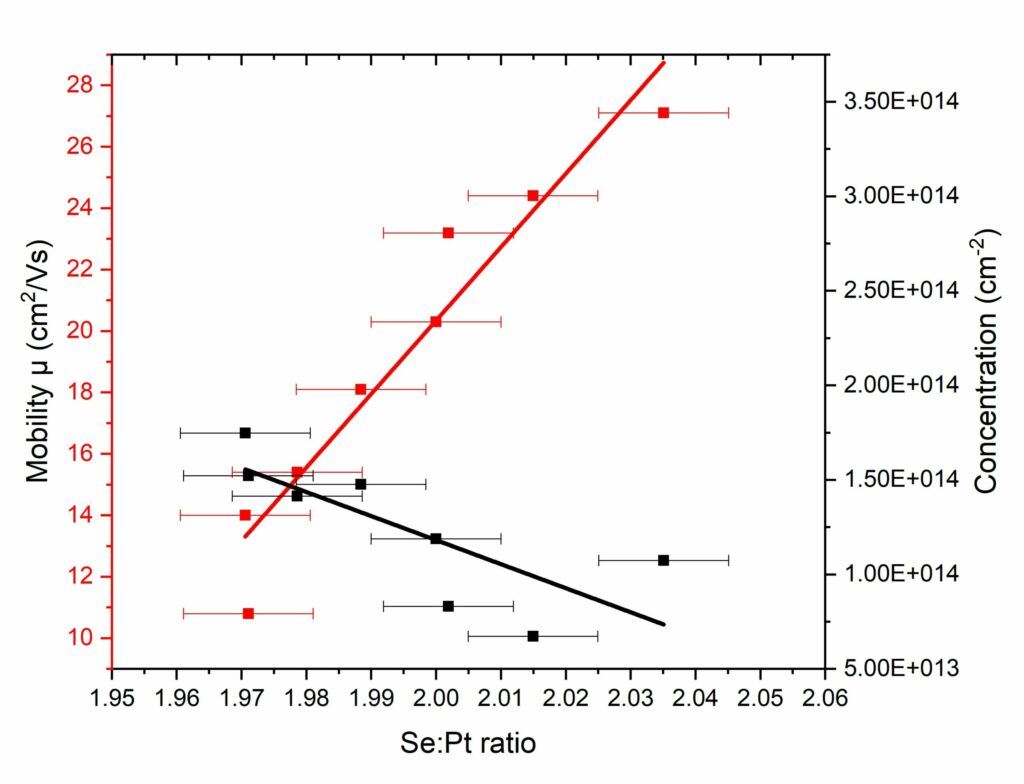
Obr. 1 Pomer Se: Pt vs. pohyblivosť nosičov náboja a koncentrácia nosičov PtSe2 vrstiev pripravených selenizáciou 1 nm hrubej vrstvy Pt pri 550 °C počas 30 minút s rôznymi prietokmi dusíka.
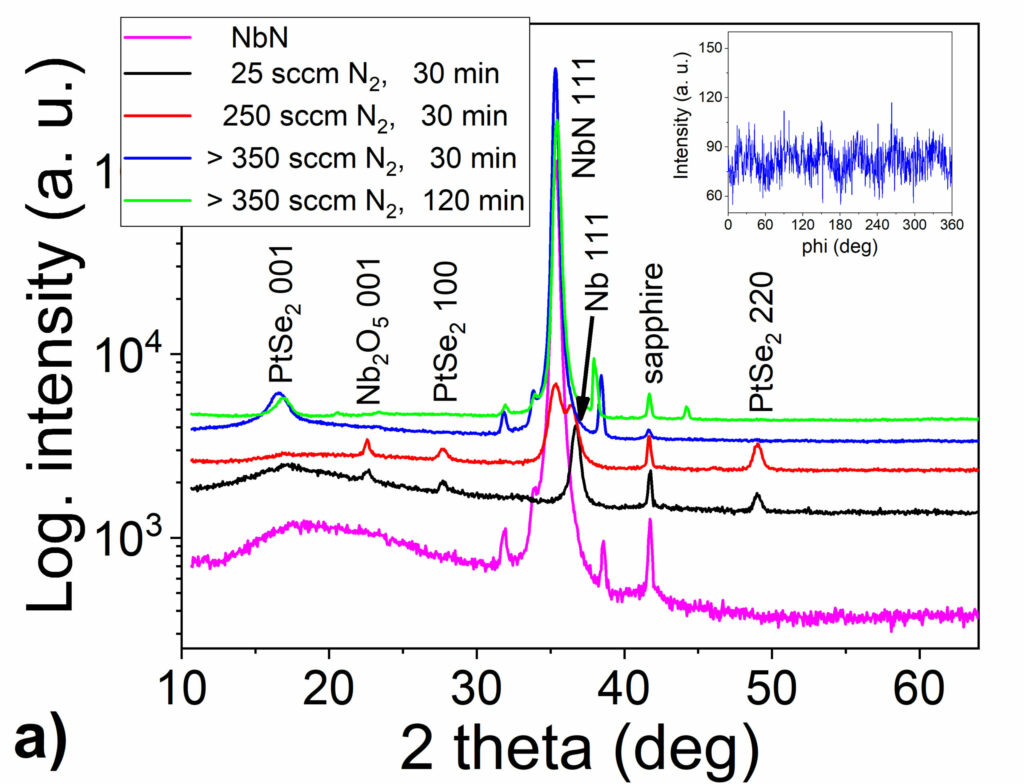
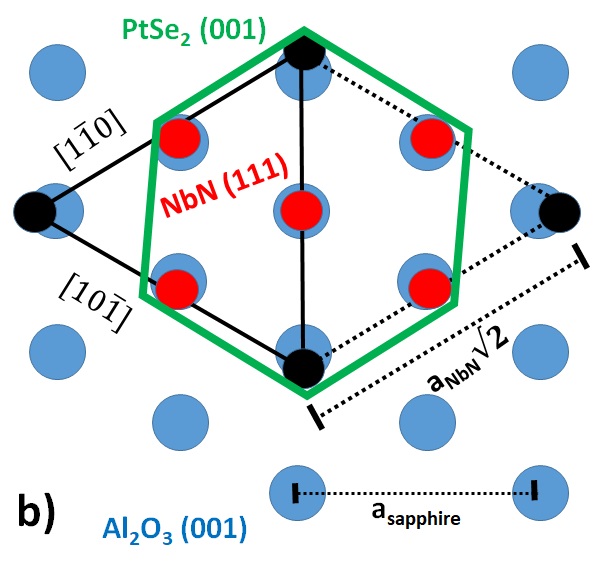
Obr. 2. (a) XRD záznam NbN vrstvy a PtSe2 vrstiev pripravených selenizáciou 3 nm hrubej vrstvy platiny pri 550 °C na NbN podložke s použitím rôznych prietokov dusíka. (b) Schematický náčrt zobrazujúci usporiadanie vrstiev PtSe2 na NbN/zafírovom substráte.
Výstupy:
1. Sojková, M., Dobročka, E., Hutár, P., Tašková, V., Pribusová Slušná, L., Stoklas, R., Píš, I., Bondino, F., Munnik, F., and Hulman, M.: High carrier mobility epitaxially aligned PtSe2 films grown by one-zone selenization, Applied Surface Sci 538 (2021) 147936.
2. Hrdá, J., Tašková, V., Vojteková, T., Pribusová Slušná, L., Dobročka, E., Píš, I., Bondino, F., Hulman, M., and Sojková, M.: Tuning the charge carrier mobility in few-layer PtSe2 films by Se: Pt ratio, RSC Adv. 11 (2021) 27292.
3. Sojková, M., Hrdá, J., Volkov, S., Vegso, K., Shaji, A., Vojteková, T., Pribusová Slušná, L., Gál, N., Dobročka, E., Šiffalovič, P., Roch, T., Gregor, M., and Hulman, M.: Growth of PtSe2 few-layer films on NbN superconducting substrate, Applied Phys. Lett. 119 (2021) 013101.
2020
Nehomogenity Schottkyho bariéry detektorov s povrchovou bariérou na báze 4H-SiC
Meraniami elektrických charakteristík (I-V a C-V merania) sme vyšetrovali výšku Schottkyho bariéry štruktúr Au/Ni/4H-SiC určených pre detektory rádioaktívneho žiarenia s povrchovou bariérou. Analýza troch parametrov diód – výšky bariéry, faktora ideality a sériového odporu ukázala, že bariéry nemožno chrakterizovať len jednou homogénnou výškou baréry po celom povrchu diódy. Následne sme bariéru analyzovali na základe rozpracovanej teórie nehomogenity bariéry s predpokladom jej Gaussovského rozdelenia. Experimentálne I-V krivky sme simulovali pomocou dvoch odlišných vplyvov sériového odporu, pomocou dvoch odlišných algoritmov. V prvom prípade sme predpokladali, že Schottkyho dióda je tvorená množstvom paralelne zapojených neinteragujúcich menších diód a každá z nich má svoj vlastný sériový odpor. Druhý prístup opäť predpokladal paralelné radenie malých diód avšak s jedným spoločným sériovým odporom. V oboch prípadoch sme hľadali tri parametre – strednú hodnotu Gaussovského rozdelenia bariér, strednú kvadratickú odchýlku rozdelenia a sériový odpor diódy.
Výsledky simulácii ukázali, že I-V krivky je možné veľmi dobre fitovať pomocou prvého prístupu neinteragujúcich diód, zatiaľ čo druhý ukazuje podstane väčšie odchýlky od reálne zmeraných dát.

Výstupy:
Osvald, J., Hrubčín, L., and Zaťko, B.: Schottky barrier height inhomogeneity in 4H-SiC surface barrier detectors, Applied Surface Sci 533 (2020) 147389.
2019
2018
2017
- Termo-mechanická analýza nechladeného La0.67Sr0.33MnO3 mikrobolometera pripraveného na kruhovej SOI membráne
2016
2015
- Detektor terahetzových vĺn
- Nanoobrábanie s následným dolešťovaním aktívnych povrchov rtg kryštálovej optiky
2014
- Polovodičový snímač tlaku pre extrémne podmienky
- Spektrometrický detektor ťažkých iónov na báze 4H-SiC
2013
- Rtg zobrazovanie ľahkých vzoriek s využitím fázového kontrastu
- Spôsob tvarovania tenkých supravodivých vrstiev na báze tália





