2024
InN/InAlN heteroštruktúry pre novú generáciu rýchlej elektroniky
V tejto práci sme pripravili heteroštruktúry na báze InN/In0.61Al0.39N s dusíkovou (N) polaritou pomocou chemickej depozície z pár organokovov priamo na zafírovom susbtráte. Hrúbka InN vrstvy bola 20 nm a InAlN vrstvy bola 340 nm. Počas rastu takejto štruktúry sme otestovali vplyv tenkej AlN vrstvy vloženej medzi InN a InAlN, pripravenej pri teplote 710 °C počas 35 s. Táto vrstva poslúžila ako medzivrstva na oddelenie podložnej InAlN vrstvy a InN kanála alebo ako súčasť nukleácie podložnej InAlN vrstvy po nitridácii zafírového substrátu. Snímok získaný pomocou vysoko-rozlišovacej transmisnej elektrónovej mikroskopie odhalil, že v prípade využitia AlN ako medzivrstvy mala táto hrúbku len približne dve atomárne vrstvy. V tomto prípade sme pozorovali zlepšenie v podobe zníženia koncentrácie skrutkových a hranových dislokácií v čiastočne napnutej vrstve InN na 6.5 × 109 a 38 × 109 cm-2. Vďaka použitiu tejto AlN medzivrstvy sme taktiež dosiahli potlačenie rozptylu elektrónov spôsobenom tzv. vzdialenými donormi mriežkovým neusporiadaním typickým pre ternárne zlúčeninové polovodiče. Tento krok nám umožnil dosiahnuť vysokú pohyblivosť a koncentráciu elektrónov v InN na úrovni 620 cm2/Vs and 3×1013 cm-2 pri izbovej teplote. Pomocou elektrických meraní za pomoci ultrakrátkych pulzov o dĺžke 10 ns na vyrobených testovacích rezistoroch sme pre InN vrstvu demonštrovali prúdovú hustotu 12-16 A/mm, prierazné elektrické pole ~75 kV/cm a driftovú rýchlosť elektrónov na úrovni ~2×107 cm/s, čo nás priblížilo k praktickým súčiastkám schopných činnosti pri ultravysokých, sub-THz frekvenciách pri izbovej teplote.
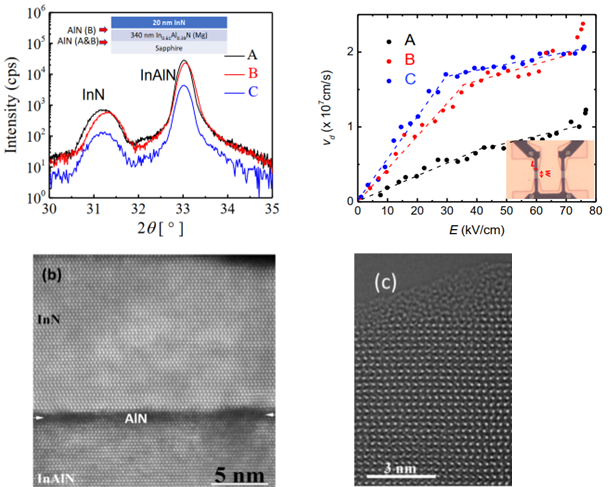
RTG difrakčný záznam pre 20 nm hrubé vrstvy InN na Mg-dopovanej In0.61Al0.39N podložnej vrstve rastenej na zafírovom substráte (vľavo), dosiahnutá driftová rýchlosť elektrónov určená z meraní na testovacích rezistoroch (vpravo), snímka z transmisného elektrónového mikroskopu s vysokým rozlíšením znázorňujúca rez kvantovou jamou InN/AlN/InAlN a detail N polarity pripravenej štruktúry (dole).
Projekt: APVV 21-0008, PEGANEL – p-GaN elektronika pre úsporu energie a post-CMOS obvody/p-GaN electronics for energy savings and beyond-CMOS circuits
Publikácia: Kuzmík, J., Stoklas, R., Hasenöhrl, S., Dobročka, E., Kučera, M., Eliáš, P., Gucmann, F., Gregušová, D., Haščík, Š., Kaleta, A., Chauvat, M.P., Kret, S., and Ruterana, P., InN/InAlN heterostructures for new generation of fast electronics, J. Applied Phys. 135 (2024) 245701.
Zlepšenie tepelných vlastností InGaAs/GaAs nanomembrán HEMT prevedených na rôzne substráty epitaxným lift-off procesom
V tejto spoločnej štúdii s Wuhanskou a Slovenskou technickou univerzitou sme sa zamerali na inováciu v oblasti tranzistorov s vysokou pohyblivosťou elektrónov (HEMT) pripravených z polovodiča GaAs. Tieto súčiastky sú kľúčové najmä v aplikáciách vysokofrekvenčnej bezdrôtovej komunikácie v spotrebiteľských, obranných a vesmírnych aplikáciách a taktiež v technológii kvantového počítania, kde sa vo veľkej miere spolieha na použitie zosilňovačov na báze zlúčeninových polovodičov. Tie umožňujú vysokofrekvenčnú nízkošumovú prevádzku aj pri kryogénnych teplotách, nevyhnutnú pre verné zosilnenie slabých qubitových stavov. V tejto štúdii sme zdokumentovali zlepšenie vlastností tepelného transportu GaAs nanomembrán prenesených z pôvodného GaAs substrátu na cudzie substráty (zafír, Si a SiC) s rôznou tepelnou vodivosťou. Takéto nanomembrány tvoria základnú vrstvu štruktúry, z ktorej je neskôr vyrobený tranzistor. Pre oddelenie nanomembrán z pôvodného substrátu bola použitá technika tzv. epitaxného oddelenia (ELO). Tieto na cudzom substráte vytvorili mechanickú väzbu pomocou van der Waalsových síl. Pre tepelnú charakterizáciu nanomembrán bola použitá nedeštruktívna optická metóda tzv. transientná termoreflektancia (TTR), ktorá bola skombinovaná s elektrotepelnou simuláciou kompletnej GaAs HEMT súčiastky pre overenie zlepšenia jej vlastností. Simulácia bola rozšírená tak, aby zahŕňala aj diamantový substrát. Táto fyzikálna simulácia ukázala významný pokles samoohrevu a tepelného odporu súčiastok (Rth) až na úrovni ~30% v prípade, že bol použitý SiC a diamantový substrát. Zároveň simulácie naznačujú, že optimalizácia rozhrania medzi GaAs a substrátom by mohla ešte viac znížiť operačnú teplotu súčiastok, v ideálnom prípade až o 29 – 41 %. Tieto výsledky potvrdzujú potenciál technológie ELO, keďže súčiastky pripravené na prenesených nanomembránach po ich vytvarované môžu poskytnúť dosiahnutie vyššieho výkonu pri udržaní všetkých ich operačných vlastností a bez rizika prehriatia. Výskum tiež zdôrazňuje ekonomický potenciál substrátov SiC, ktoré sú cenovo dostupnejšie aj rozmernejšie ako diamant, pričom stále poskytujú podobné výhody v oblasti zlepšeného odvodu tepla. Okrem toho, použitie technológie ELO umožňuje opätovné využitie GaAs substrátov, čím sa znižujú výrobné náklady a zvyšuje udržateľnosť výrobného procesu.
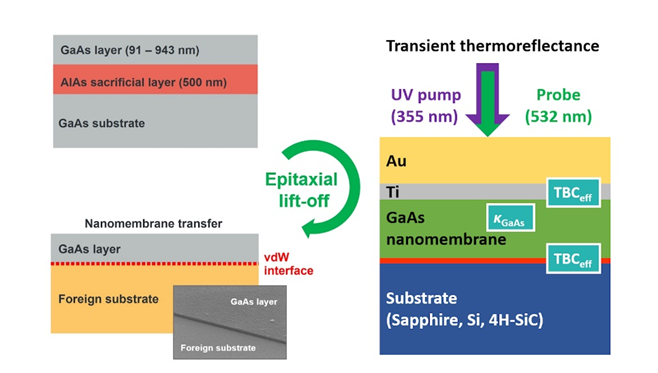
Schematické vyobrazenie techniky ELO – oddelenie GaAs nanomembrány a jej prenesenie na cudzí substrát (vľavo) a schematický prierez štruktúrou použitou na meranie tepelných vlastností.
Zahraničný partner: Institute of Technological Sciences, Wuhan University, Čína
Súvisiaci medzinárodný projekt: APVV SK-CN-21-0013, Vlastnosti tepelného transportu v budúcich perspektívnych polovodičových materiáloch a rozhraniach/Thermal transport properties of perspective future semiconductor materials and interfaces (zodp. riešiteľ F. Gucmann).
Publikácia: Gucmann, F., Meng, B., Chvála, A., Kúdela, R., Yuan, C., Ťapajna, M., Florovič, M., Egyenes, F., Eliáš, P., Hrubišák, F., Kováč, J.Jr., Fedor, J., and Gregušová, D. Improved thermal performance of InGaAs/GaAs nanomembrane HEMTs transferred onto various substrates by epitaxial lift-off, ACS Applied Electron. Mater. 6 (2024) 5651–5660.
2023
Vertikálny tranzistor so semiizolačným kanálom
Výkonová elektronika založená na GaN sa stáva nevyhnutnou pre efektívnu premenu energie. Vertikálna geometria súčiastok je tu nevyhnutná na zníženie parazitných efektov, ako je samozahrievanie a zachytávanie náboja na povrchu. Demonštrujeme nový zjednodušený koncept vertikálnych GaN tranzistorov s C-dopovanou 1,3-mm hrubou kvázi-izolačnou (SI) kanálovou vrstvou. Štruktúry boli rastené pomocou kovovej organickej chemickej depozície pár na vodivých substrátoch GaN. SI GaN je vložený medzi 2,5-mm hrubú n-GaN driftovú vrstvu a hornú n-GaN kontaktnú vrstvu. Kontakt hradla je vytvorený na bočnej stene štruktúry a je izolovaný od vertikálneho kanála pomocou Al2O3 rasteného depozíciou po atómových vrstvách. Robustné usporiadanie súčiastky, chýbajúci doping typu p, perspektívna škálovateľnosť prierazného napätia bez zníženia dopingu typu n v oblasti driftu a vysoká mobilita elektrónov v kanáli sú hlavnými výhodami tohto prístupu. Naša štúdia poskytuje impulz pre ďalší rozvoj.
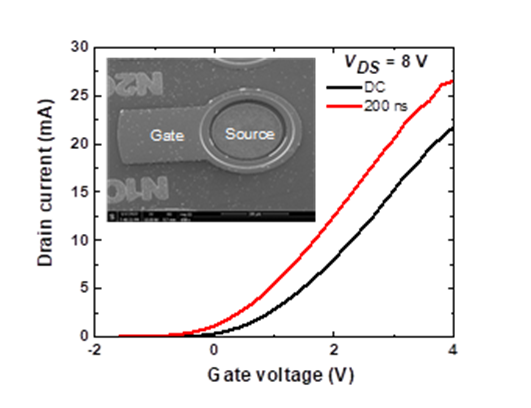
Prevodové charakteristiky vertikálneho GaN tranzistora. Vložený obrázok predstavuje pohľad zhora na zhotovenú štruktúru.
Šichman, P., Stoklas, R., Hasenöhrl, S., Gregušová, D., Ťapajna, M., Hudec, B., Haščík, Š., Hashizume, T., Chvála, A., Šatka, A., and Kuzmík, J.: Vertical GaN transistor with semi-insulating channel, Physica Status Solidi (a) 220 (2023) SI2200776.
J. Kuzmik: Vertical GaN transistor with insulating channel and the method of forming the same, Slovak patent No. 289027 (granted), European patent pending no. EP18830014.9.
Rast vrsiev InAlN s vysokým obsahom In N-polarity metódou chemickej depozície z pár organokovov na odklonených a neodklonených zafírových podložkách
V tejto práci sme využili metódu chemickej depozície z pár organokovov (MOCVD) na prípravu vrstiev InAlN s vysokým obsahom india a N-polarity priamo na zafírových podložkách neodklonených od c-roviny alebo odklonených od c-roviny o 4° smerom k a-rovine a sledovali zmenu materiálových vlastností InAlN vzhľadom na zmenu zvoleného rastového prietoku In prekurzora (trimetylindium, TMIn) v rozsahu 8,42 – 13,48 μmol/min. So zvyšujúcim sa prietokom TMIn sme pozorovali nárast obsahu In v InAlN vrstvách až do výšky 55 – 69% bez ohľadu na odklon zafírového substrátu. Pre menej ako 63%-ný obsah In sme dosiahli na neodklonených substrátoch zníženie kryštalických porúch, avšak použitie odklonených substrátov viedlo k nižšej povrchovej drsnosti InAlN vrstiev. Vďaka týmto zisteniam sme potvrdili vhodnosť N-polárnych InAlN vrstiev s vysokým obsahom In ako vhodnej prispôsobovacej vrstvy pre nové typy heteroštruktúrnych mikroelektronických súčiastok.
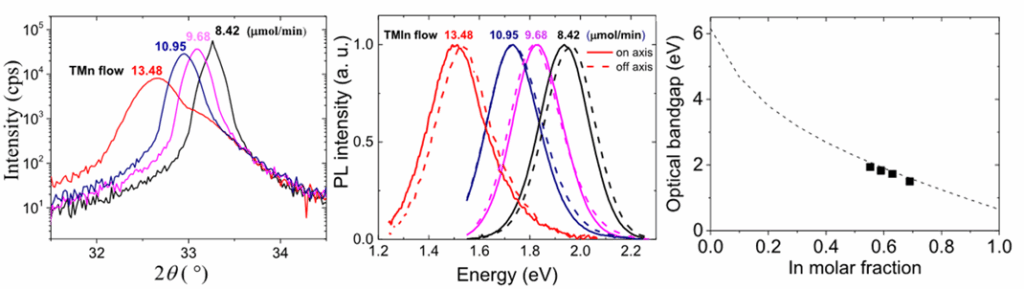
RTG difrakčný záznam (vľavo) a fotoluminiscenčné spektrá (v strede) pre InAlN vrstvy pripravené pri rôznych prietokoch In prekurzora. Vypočítané hodnoty energie optického zakázaného pásma InN pre rôzny obsah india (vpravo).
Riešitelia: S. Hasenöhrl, M. Blaho, E. Dobročka, F. Gucmann, M. Kučera, P. Nádaždy, R. Stoklas, A. Rosová, J. Kuzmík
Projekt: VEGA 2/0005/22 (zodp. riešiteľ J. Kuzmík)
Hasenöhrl, S., Blaho, M., Dobročka, E., Gucmann, F., Kučera, M., Nádaždy, P., Stoklas, R., Rosová, A., and Kuzmík, J.: Growth of N-polar In-rich InAlN by metal organic chemical vapor deposition on on- and off-axis sapphire, Mater. Sci Semicond. Process. 156 (2023) 107290.
Heteroepitaxiálny rast Ga2O3 na 4H-SiC pomocou MOCVD s kvapalným vstrekovaním na zlepšenie tepelného riadenia výkonových zariadení s Ga2O3
V tejto štúdii sme sa venovali integrácii nového polovodiča Ga2O3 s podložkami SiC za účelom optimalizácie tepelných vlastností výkonových Ga2O3 súčiastok. Hlavnou výhodou Ga2O3 je jeho vysoké teoretické prierazné pole a široké zakázané pásmo. Vysoké prierazné pole potenciálne umožňuje použitie Ga2O3 pre vysokonapäťové súčiastky zatiaľ čo široké zakázané pásmo otvára možnosti jeho využitia pre optoelektronické súčiastky pracujúce v hlbokej UV oblasti. Ga2O3 má niekoľko kryštalických fáz, z ktorých boli v tomto prípade skúmané β-Ga2O3 a κ-Ga2O3.
Jednou za hlavných nevýhod Ga2O3 je jeho nízka tepelná vodivosť, ktorá predstavuje obmedzenie výkonového rozsahu ako aj životnosť súčiastok na báze Ga2O3. Práve problematike nízke tepelnej vodivosti a možných náhradným riešeniam sa venujeme v tejto publikácii. Tento problém sme sa pokúsili riešiť rastom Ga2O3 vrstiev na substrátoch SiC s vysokou tepelnou vodivosťou. Na základe kombinácie tepelných meraní a simulácie sme zistili, že umiestnenie tenkých Ga2O3 vrstiev na SiC umožňuje významné zníženie samoohrevu tranzistorov oproti súčiastkam pripraveným na Ga2O3 substráte (až takmer 30× pre hrúbku < 2 µm) a taktiež, že medzi Ga2O3 vrstvami a SiC substrátom nevzniká významná tepelná bariéra, ktorá by zásadne bránila odvodu stratového tepla.
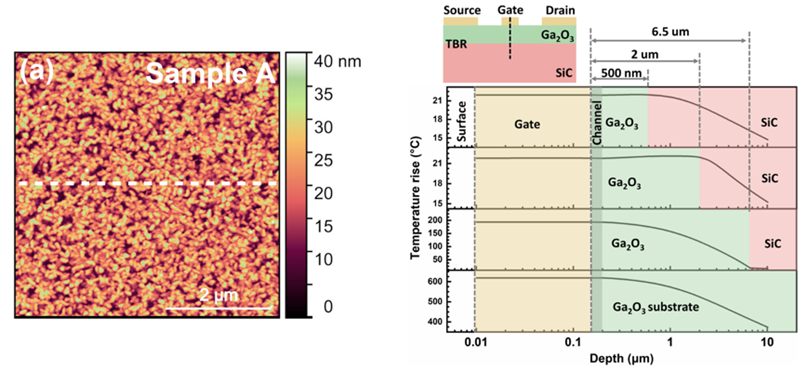
Povrch Ga2O3 vrstvy zobrazený mikroskopom atomárnych síl (vľavo) a výsledok simulácie samoohrevu ochudobňovacieho poľom riadeného tranzistora (MOSFET) vyrobeného z nami pripravených Ga2O3 vrstiev na SiC (vpravo). Simulácia ukazuje, že pri zachovaní hrúbky kanála 2 μm je samoohrev súčiastky nebadateľný oproti vyšším hrúbkam, resp. prípadu typicky použitého Ga2O3 substrátu namiesto SiC.
Hrubišák, F., Hušeková, K., Zheng, X., Rosová, A., Dobročka, E., Ťapajna, M., Mičušík, M., Nádaždy, P., Egyenes, F., Keshtkar, J., Kováčová, E., Pomeroy, J.W., Kuball, M., and Gucmann, F.: Heteroepitaxial growth of Ga2O3 on 4H-SiC by liquid-injection MOCVD for improved thermal management of Ga2O3 power devices, J. Vacuum Sci Technol. A 41 (2023) 042708.
2022
3D rast In(Ga)N na GaN-buffered on-axis a off-axis (0001) zafírových substrátoch pomocou MOCVD
Nedávne pokroky v epitaxnom raste vrstiev nitridu india otvorili nové obzory pre fotonické a elektronické zariadenia. V našej skupine sme študovali rast samostatne zostavených pyramíd InN nano veľkosti na zafírových substrátoch s GaN nárazníkovou vrstvou s dvoma rôznymi sklonmi povrchu. Súvislá vrstva malých In(Ga)N kužeľových pyramíd (výška ~10-25 nm), bola alternovaná s veľkými kužeľovými pyramídami s približnou výškou 50-80 nm. Nízkoteplotné fotoluminiscenčné spektrá vykazovali maximum pri 853 meV s plnou šírkou pri polovičnom maxime (FWHM) 75 meV a 859 meV s FWHM 80 meV pre substráty s povrchom mimo a pozdĺž roviny c.
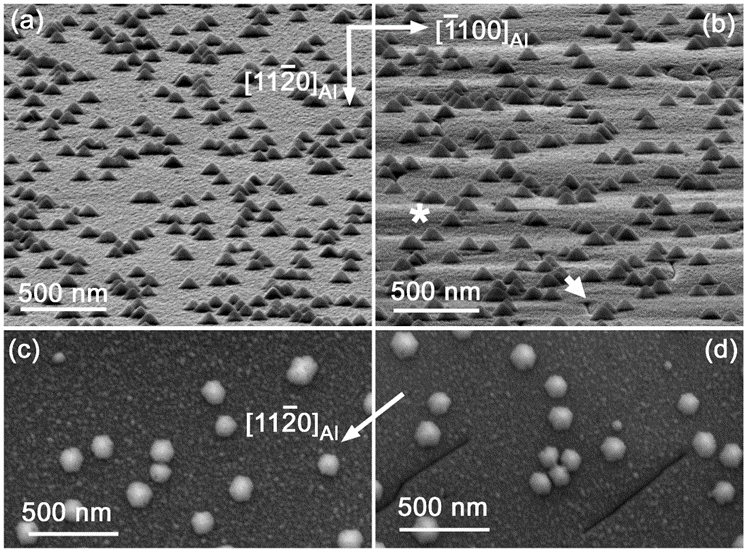
SEM snímky vrstiev In(Ga)N rastených na substrátoch GaN/Al2O3 na osi (a, c) a mimo osi (b, d). (a) a (b) snímky boli urobené so vzorkou naklonenou o 85° od normály povrchu; (c) a (d) sú rovinné obrazy orientované podľa znázorneného smeru substrátu Al203. Hviezdička v (b) označuje jasne viditeľné schodíky súvisiace s mimoosovým substrátom; hrubá krátka šípka ukazuje na jednu z pozorovaných trhlín.
Rosová, A., Dobročka, E., Eliáš, P., Hasenöhrl, S., Kučera, M., Gucmann, F., and Kuzmík, J.: In(Ga)N 3D growth on GaN-buffered on-axis and off-axis (0001) sapphire substrates by MOCVD, Nanomater. 12 (2022) 3496.
2021
InN: prielom v elektronike tuhej fázy
InN patrí medzi popredných kandidátov pre materiál s najvyššou elektrónovou rýchlosťou. Avšak tento teoretický predpoklad nebol nikdy potvrdený. V tejto práci demonštrujeme súčastnú úroveň InN materiálu s driftovou elektrónovou rýchlosťou okolo 1 × 108 cms-1 pri elektrickom poli 48 kVcm-1. Toto je najvyššia ustálená elektrónová rýchlosť aká bola kedy meraná v hocijakej súčiastke tuhej fázy. Naviac, naša experimentálna hodnota 2 Í presahuje teoretické predpoklady, naznačujúc, že je potrebné prehodnotiť chápanie fundamentálnych vlastností InN materiálu. Pokiaľ sa podarí plne zvládnuť technológiu tranzistorov na báze InN kanála, súčastná THz frekvenčná diera medzi elektronickými a optickými súčiastkami bude odstránená.
Táto práca bola realizovaná v spolupráci s University of Crete a MRG IESL Crete.

Prúdovo-napäťová charakterizácia a extrakcia elektrónovej rýchlosti v InN odporoch. (a) Typická 10-ns dlhá prúdovo-napäťová vlna. Doba nábehu a poklesu bola okolo 6 ns. Za účelom konštrukcie prúdovo-napäťovej charakteristiky na obr. (b), vlnové funkcie boli spriemerované v 2-ns časovom okne okolo maxima. Náčrt meracej schémy je vložený do obrázku (a). HP 8114A 100 V/2 A bol použitý ako programovateľný generátor pulzov, Rm = 8.5 W. (b) Závislosť prúdovej hustoty od aplikovaného elektrického pola (ľavá y os) a odpovedajúca extrahovaná elektrónová driftová rýchlosť (pravá y os) série InN odporov. Prerušovaná čiara interpoluje hodnoty. Vložený obrázok predstavuje záber optického mikroskopa na dva 8-mm dlhé a 4-mm široké InN testovacie odpory. Nezlievané Ti/Al/Ni/Au ohmické kontakty a spodný GaN povrch leptaný plazmou je jasne rozlíšiteľný.
J. Kuzmík, A. Adikimenakis, M. Ťapajna, D. Gregušová, Š. Haščík, E. Dobročka, K. Tsagaraki, R. Stoklas, A. Georgakilas: InN: breaking the limits of solid-state electronics, AIP Advances 11 (2021) 125325.
2020
Rast a vlastnosti InN/InAlN Heteroštruktúr s N polaritou
InN je označovaný ako sľubný materiál pre prípravu ultra-rýchlych tranzistorov. Táto skutočnosť vyplýva predovšetkým z teoreticky vypočítanej driftovej rýchlosti elektrónov, ktorá je najvyššia spomedzi všetkých známych polovodičov. Avšak mikrovlnný transistor s InN kanálom sa doteraz nikomu nepodarilo demonštrovať. Dá sa však predpokladať, že pokiaľ použijeme InAlN s vysokým obsahom In ako nárazníkovú vrstvu, na ňom narastený InN bude vykazovať menšie mriežkové prispôsobenie a menšie pnutie. Takto sa zmenší hustota dislokácií v InN oproti štandartnému rastu na GaN-e. Uvedeným spôsobom sa podarilo demonštrovať decentnú elektrónovú vodivosť 720 cm2V-1s-1 v N polárnej InN/InAlN heteroštruktúre, pričom hrúbka InN bola len 20 nm. Zistili sme, že v dôsledku lepšej kryštalografickej kvality, hallovské hodnoty transportných vlastností elektrónov v InN/InAlN heteroštruktúre narastenej na zafíre s povrchom paralerne s kryštalografickou rovinou sú lepšie ako tie narastené na odklonenej rovine. Ďalšie vylepšenie pohyblivosti nad súčastný štandart možno očakávať vyhladením povrchu InAlN, ďalším nárastom obsahu In v InAlN a kompenzáciou neúmyselných donorov v InAlN-e. V našej práci sme popísali nevyhnutné kroky smerom k demonštrácií mikrovlnných tranzistorov s InN kanálom.

a) XRD 2θ/ω difrakcia v InN(20 nm)/In0.57Al0.43N heteroštruktúre narastenej na neodklonenom zafíre, b) 2D a 3D pohľad na 2×2 µm2 AFM sken 20 nm hrubej InN narastenej na N polárnej In0.57Al0.43N vrstve, c) Pohyblivosť a koncentrácia elektrónov v InN v závislosti od hrúbky vrstvy.
Hasenöhrl, S., Dobročka, E., Stoklas, R., Gucmann, F., Rosová, A., and Kuzmík, J.: Growth and Properties of N-polar InN/InAlN Heterostructures, Phys. Stat. sol (a) 217 (2020) 2000197.
Kučera, M., Hasenöhrl, S., Dobročka, E., Rosová, A., Eliáš, P., Gucmann, F., and Kuzmík, J.: Morphology, crystalline quality, and optical properties of MOCVDgrown InN/InAlN heterostructures. In: ASDAM 2020. Eds. T. Izsák et al. IEEE 2020. ISBN 978-1-7281-9776-0. P. 131-134.
2019
2018
2017
2016
2015
2014
- Technologický transfer normálne zatvoreného výkonového tranzistora typu AlGaN/GaN HEMT do Ferdinand Braun Institute Berlin
- Optimalizácia návrhu výkonového spínacieho tranzistora AlGaN/GaN HEMT
- Elektrickým poľom ovládané tranzistory typu kov-oxid-polovodič na heteroštruktúre InGaAs/GaAs s dvojvrstvovým hradlovým dielektrikom zloženým z oxidu pripraveného pomocou kyslíkovej plazmy a Al2O3
2013
- Záchyt v objeme a na rozhraní v hradlovom oxide tranzistorov GaN s vysokou pohyblivosťou elektrónov
- GaN/InAlN/AlN/GaN tranzistor s vysokou pohyblivosťou elektrónov s Schottkyho bariérou a so selektívnym odleptaním prístupových oblastí
- Radiálny PN prechod na nanodrôte GaP/ZnO
2012
- InN/GaN/InAlN tranzistory s vysokou pohyblivosťou elektrónov a N polaritou
- Všeobecný analytický model výpočtu prahového napätia v GaN heteroštruktúrnych tranzistoroch typu kov-oxid-polovodič
- Technológia prípravy nanostlpikov pre fotovoltaické aplikácie
- Výskum vlastností tranzistorov s in-situ pasivačnou vrstvou na báze GaAs





