Vysoko kremíkom dopované vrstvy nitridu gália (n++ GaN) zohrávajú dôležitú úlohu pri vývoji moderných tranzistorov s vysokou pohyblivosťou elektrónov (HEMT), ktoré sa uplatňujú v telekomunikáciách aj výkonovej elektronike.
Naši kolegovia a kolegyne z oddelenia III-V polovodičov skúmali rast týchto vrstiev pomocou techniky MOCVD pri teplote 800 °C a analyzovali, ako prietok kremíkového prekurzora (SiH₄) ovplyvňuje ich kvalitu a vodivosť. Optimalizáciou parametrov dosiahli koncentráciu voľných elektrónov až 7,2 × 10¹⁹ cm⁻³ a elektrónovú pohyblivosť 103 cm²/Vs. Tenká (~8 nm) GaN vrstva funguje ako účinná pasivácia povrchu a eliminuje tzv. current collapse efekt – stratu prúdu pri spínaní.
„Ukázali sme, že voľné elektróny v n++ GaN vrstve dokážu účinne tieniť kanál tranzistora pred nestabilným povrchovým potenciálom. Vďaka tomu dosahujeme stabilný prúd a spoľahlivú prevádzku aj pri vysokých záťažiach,“ vysvetľuje Ján Kuzmík, hlavný autor štúdie.
Ďalšie merania potvrdili, že využitie tzv. flow modulation epitaxy ešte zvyšuje koncentráciu voľných nosičov až do oblasti 10²⁰ cm⁻³, čo prináša nové možnosti pre návrh tranzistorov s normálne zatvorenou štruktúrou (normally-off HEMTs).
Výsledky publikoval kolektív z Elektrotechnického ústavu SAV v časopise Materials Science in Semiconductor Processing.
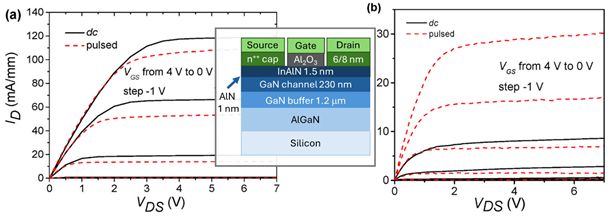
Výstupné charakteristiky HEMT s a) 8 nm a b) 6 nm n++ čiapočkou (z angl. cap, tmavozelená) v dc a pulznom režime.





