Application of GaN-based switching devices (transistors) can lead to suppression of conversion losses in AC/DC and DC/DC converters, when compared to state-of-the-art Si counterparts. This could potentially lead to energy savings with the scale 10-times exceeding supply of renewable generation. Consortia of 7FP EU project HipoSwitch, in which we took a part, aimed the development of full added-value chain based in EU for this new technology. One of the issues identified during the project implementation was the gate-electrode reliability of the GaN transistor operating in ON state. In cooperation with Ferdinand-Braun Institute Berlin (Germany), we investigated the gate degradation upon electrical stress in such conditions. Using the appropriate statistic techniques, we extrapolated the safe operation area for the gate voltage guaranteeing 10-years-lifetime. The results were published in the international conference and renowned scientific journals Applied Physics Letters and IEEE Electron Device Letters.
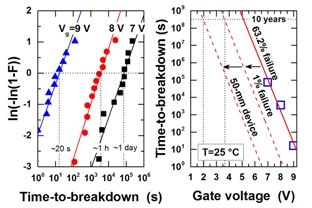
Ťapajna, M., Hilt, O., Bahat-Treidel, E., Würfl, J., and Kuzmík, J.: Gate reliability investigation in normally-off p-type-gan cap/AlGaN/GaN HEMTs under forward bias stress, IEEE Electron Device Lett. 37 (2016) 385 – 388.
Ťapajna, M., Hilt, O., Bahat-Triedel, E., Würfl, H., and Kuzmík, J.: Investigation of gate-diode degradation in normally-off p-GaN/AlGaN/GaN high-electron-mobility transistors, Applied Phys. Lett. 107 (2015) 193506.
Ťapajna, M., Hilt, O., Bahat-Treidel, E., Würfl, J., and Kuzmík, J.: Gate robustness analysis of normally-off p-GaN HEMTs for high power switching applications, In: Proc. 39th Workshop on Compound Semiconductor Devices and Integrated Circuits, WOCSDICE 2015. P. 67-68.





